ウェハ外観検査装置

特徴
- LSI、LD(レーザーダイオード)、DI、LED、パワー半導体、MEMS、化合物半導体など、多岐にわたる半導体の検査が可能
- ミクロ検査対応: 微細なパターン異常、異物、塗布不良など、チップ性能に直結する回路欠陥の詳細解析を実現
- マクロ検査対応: ウェハ全体のワレ、カケ、クラック、スクラッチといった物理的損傷や、広範囲のムラを高速で検出
- 検査内容に応じて、カラー・モノクロ検査、表面検査・表裏面検査、エリア・ラインカメラなど、最適な機能を自由に選択・構築可能。
- 豊富なオプション機能による高精度検査が可能
概要
■高速・高精度なウェハ外観検査装置
本製品は、製造工程で発生するクラック、異物、スクラッチ、パターン異常などの外観欠陥を高速かつ高精度に検査する外観検査装置です。
従来のLSIやLEDに加え、汎用機では対応が難しい、LD、DI、パワー半導体、CMOSイメージセンサ、フォトダイオード、MEMS、化合物半導体(SiC/GaNなど)といった特殊ウェハの欠陥検査にも対応しています。
LSI・LEDから最新デバイスまでを網羅する柔軟性で、製造ラインの品質管理と歩留まり最大化を強力にサポートします。
■欠陥の種類に応じた「カスタム検査」
検査対象となる欠陥の性質に基づき、最適な検査機能を選択・構築できます。
ミクロ検査対応
チップ性能に直結する微細なパターン異常、異物、塗布不良など、回路欠陥の詳細解析を実現し、高集積化に対応します。
マクロ検査対応
ウェハ全体のワレ、カケ、クラック、スクラッチといった物理的損傷や広範囲のムラを高速で検出し、不良流出を未然に防ぎます。
さらに、検査内容に応じてカラー・モノクロ検査、表面検査・表裏面検査、エリア・ラインカメラの組み合わせを自由に選択可能です。
■豊富なオプション機能でさらにニーズに合ったカスタマイズ
基本的な検査機能に加え、お客様のニーズに応じた豊富なオプション機能で、検査の安定性と生産性の向上をおこないます。
オプションのオートフォーカス機能により、反りや厚みのバラつきがあるウェハでも焦点を自動調整することが可能です。
不安定なワークでも検査精度を落とすことなく、安定した検査を継続できます。
ID読込み機能やマッピングデータ出力機能(オプション)により、検査結果を生産管理システムと連携可能です。
どのウェハで、いつ、どんな不良が発生したかを追跡(トレーサビリティ)できるため、迅速な原因究明とプロセス改善に役立ちます。
■ビューワーソフトによる継続的な歩留まり改善と品質管理体制の強化
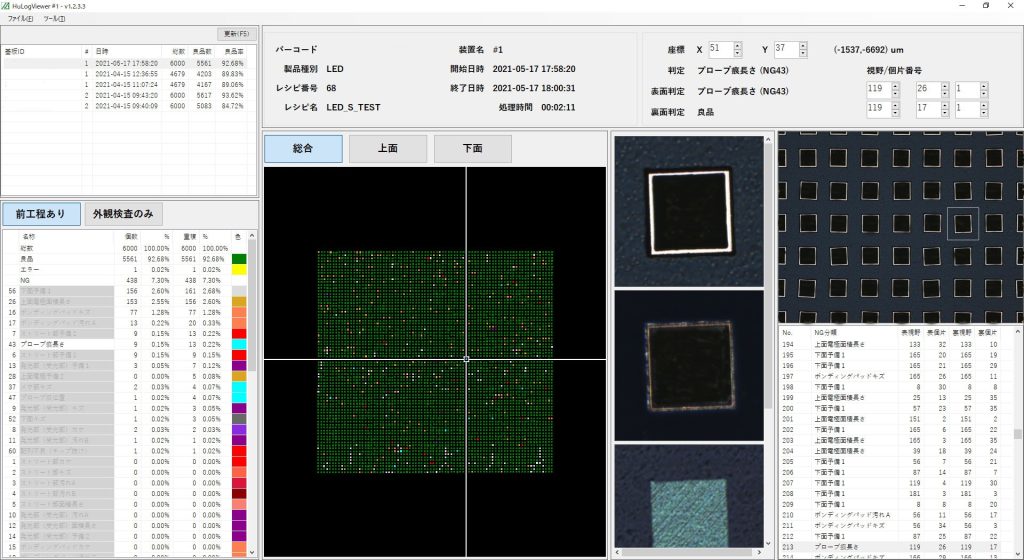
本装置に搭載されたビューワーソフトは、単に欠陥の発見や、製品の合否を判定するだけでなく、検査結果のデータ解析と可視化を強力にサポートします。
「検査結果マップ表示機能」により、ウェハ上の欠陥の分布を視覚的に把握できるため、製造装置やプロセスの偏りを迅速に特定することができます。
さらに、「NGチップ拡大表示機能」で具体的な不良箇所を瞬時に確認し、「不良分類表示機能」(不良項目別、検査総数、OK/NG別)により、どの種類の不良が多いのかを定量的に分析することが可能です。
これにより、検査データを前工程へ迅速にフィードバックすることができ、継続的な歩留まり改善と品質管理体制の強化を実現します。
仕様
| ソフトウェア | 多機能画像検査ソフト Hu-Dra |
|---|---|
| カメラ | 500万画素モノクロエリアカメラ(ミクロ検査) 1,200万画素モノクロエリアカメラ(マクロ検査) 2,500万画素モノクロエリアカメラ(アライメント) |
| 装置サイズ | 1,350W×1,350D×1,800H mm パトライト、HEPA除く |
| その他 | レンズ、照明はワークと検査内容により、選定する必要があります。 |


